CHALLENGING & GROWING HI TECHNOLOGY
R&D
방열기판(CMB 및 MCCL)
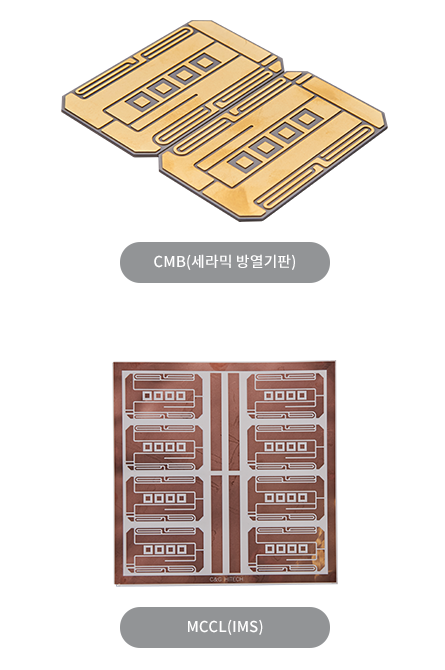
Introduction
Application
Spec(CMB)
기준시점: 2Q25
| 항목 | 절연재료 | Remark | |
|---|---|---|---|
| AlN | Si3N4 | ||
| 열전도도 | 170 W/m·K(Room Temp) | 90 W/m·K(Room Temp) | ASTM-E1461 |
| 열팽창계수 | 4.6 10-6 K(~400°C) | 2.6 10-6 K(~400°C) | |
| 절연층 두께 | 0.38 / 0.635 / 1.0 mm | 0.25 / 0.32 mm | |
| 회로층, 방열층 두께 | 0.3 / 0.5 / 0.8 / 1.0 mm | ||
| 박리 강도 | 50 N/cm 이상 | JIS C 6481 | |
| 열충격 시험 | 2,000회 이상, -40°C⇔125°C | JESD22-A104 | |
| 접합면적 | 95% 이상 | ||
| 내전압 시험 | 15 kV/mm 이상(디바이스) | ASTM-D149 | |
| 제품형태 | Unpatterned or Patterned Master card type | ||
| 제품 사이즈 | 4.5"x4.5" / 5.5"x7.5" | ||
Spec(IMS PCB)
기준시점: 2Q25
| 항목 | 절연재료 | Remark |
|---|---|---|
| Thermal Conductive Sheet(열전도 접착 시트) | ||
| 열전도도 | 10 W/m·K 이상(Room Temp) | ASTM-E1461 |
| 절연층 두께 | 0.12 ~ 2.0 mm | |
| 방열층 두께 | 0.035 ~ 4.0 mm | |
| 회로층 두께 | 0.035 ~ 1.0 mm | |
| 박리 강도 | 5 or 10 N/cm 이상 | JIS C 6481 |
| 열충격 시험 | 2,000회 이상, -40°C⇔125°C | JESD22-A104 |
| 접합면적 | 99% 이상 | |
| 내전압 시험 | 45 or 60 kV/mm 이상 | ASTM-D149 |
| 제품형태 | Unpatterned or Patterned Master Card Type Intergrated Base Plate & Heat Sink(Pin-Fin) |
|
| 제품 사이즈 | 300 x 400mm(Regular) | Negotiable |
Glass기판

Introduction
Application
Spec
기준시점: 2Q25
| 항목 | 내용 | Remark | |
|---|---|---|---|
| Glass Spec. | 종류 | Borosilicate / Boro-Aluminosilicate / Quartz 등 | |
| CTE | 3~9 (0-300 ℃, ×10-6/℃) | ||
| 계면 조도 | < 20 ㎚ | ||
| 두께 | ~ 1,500 ㎛ | ||
| TGV Ø (Through-Glass Via) |
~ 100 ㎛ | ||
| Metal Layer Spec. | 10 ㎛ 이하 | ||
| 박리강도 | 7 N/cm 이상 | ||
| 미세 회로 (Line/Space) | Min. 10/10 ㎛ | Line/Space = 5 ㎛/5 ㎛ 이하 테스트 예정 | |
| 열충격시험 | 3,000회, Delamination 미발생 | L/S = 10/10 ㎛ 1cycle(15min) : -40℃~125℃ |
|
| Through-Glass Via(TGV) Conformal & Filling Aspect Ratio |
1 : 5 | ||
| 제품 사이즈 | 510 x 515 mm | ||
저유전율 FCCL

Introduction
Application
Spec
기준시점: 2Q25
| 구분 | 유전율 | 유전손실 | 접착력 | 흡습율 | 내전압성 | 내화학성 |
|---|---|---|---|---|---|---|
| PTFE | 2.1 | 0.0003 | 매우 낮음 | 0.01 | 양호 | 매우 우수 |
| PFA | 2.1 | 0.0009 | 낮음 | 0.01 | 양호 | 매우 우수 |
| PPS | 2.9 | 0.0030 | 양호 | 0.04 | 우수 | 양호 |
| Modified PI | 2.7 | 0.0028 | 우수 | 0.60 | 우수 | 우수 |
| LCP | 3.1 | 0.0020 | 양호 | 0.04 | 우수 | 우수 |
* 상기 외 다양한 플라스틱 film에 증착/도금 가공 가능
NPP(Nano Particles on Powder)
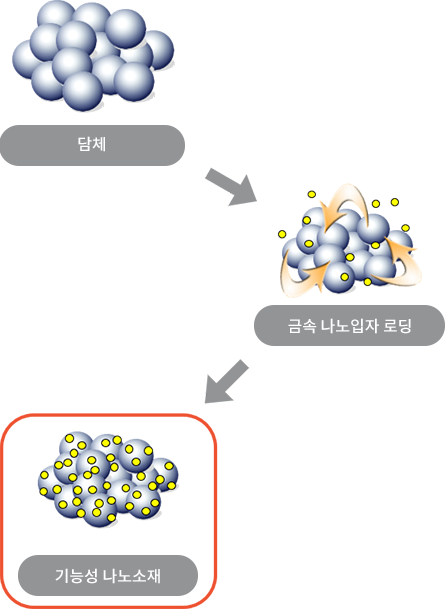
Introduction
Application
탄소융합소재 FCM(Fused Carbon Material)
